

BGA(即Ball GridAray)有多種結構,如塑封BGA (PBGA)、倒裝BGA( FBGA )、載帶BGA(TBGA)和陶瓷BGA(CBGA)。工藝特點如下:
1)、BGA引腳(焊球)位于封裝體下,肉眼無法直接觀察到焊接情況,必須采用X光設備才能檢查。
2)、BGA屬于濕敏器件,如果吸潮,容易發生變形加重、“爆米花”等不良,因此貼裝前必須確認是否符合工藝要求。
3)、BGA也屬于應力敏感器件,四角焊點應力集中,在機械應力作用下很容易被拉斷, 因此,在PCB設計時應盡可能將其布放在遠離拼板邊和安裝螺釘的地方。
總體而言,BGA焊接的工藝性非常好,但有許多特有的焊接問題,主要與BGA的封裝結構有關,特別是薄的FCBGA與PBGA,由于BGA封裝的層狀結構,焊接過程中會發生變形,一般把這種發生在焊接過程中的變形稱為動態變形,它是引起BGA組裝眾多不良的主要原因。
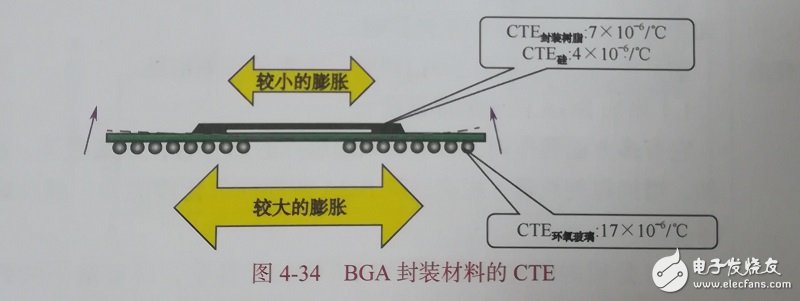
BGA組裝不良現象事項:
BGA的焊接在再流焊接溫度曲線設置方面具有指標意義。因BGA尺寸大、熱容量大,因此一般將其作為再流焊接溫度曲線設置重點監控對象。BGA的焊接缺陷譜與封裝結構、尺寸有很大關系,根據常見不良大致可以總結為:
( 1 )焊球間距《 1.0mm的BGA (或稱為CSP),主要的焊接不良為球窩、不潤濕開焊與橋連。
( 2 )焊球間距》 1.0mm的PBGA、FBGA等,因其動態變形特性,容易發生不潤濕開焊、不潤濕開裂、縮錫斷裂等特有的小概率焊接不良。這些焊接不良一般不容易通過常規檢測發現,容易流向市場,具有很大的可靠性風險。
( 3)尺寸大于25mmx 25mm的BGA,由于尺寸比較大,容易引起焊點應力斷裂、坑裂等失效。