當前,3D封裝技術正席卷半導體行業,引起整個行業的廣泛關注。如今摩爾定律趨緩,而3D封裝技術將會取而代之成為新的發展方向。因此各家公司一直在大力投資3D封裝技術,以便占據良好的競爭優勢。
圖1展示了3D封裝技術的潛在應用和大批量制造(HVM)。基本上它可以分為4類:存儲芯片堆疊,寬 I / O儲存芯片(或邏輯芯片堆疊),寬I / O DRAM和寬 I / O接口(或2.5D集成電路)。
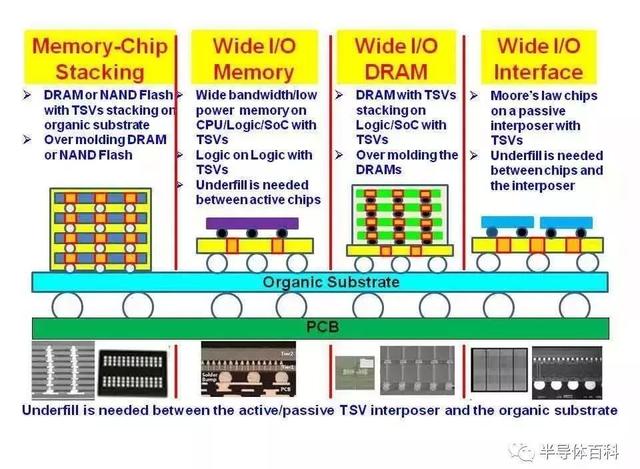
圖1:Potential application and high-volume manufacturing of 3D IC integration
存儲芯片堆疊
圖1最左端圖示是Samsung公司在2006年發布的最簡單的存儲芯片堆疊示意圖。這些芯片可能是DRAM(動態隨機存取存儲器)或I/O數量少于100的NAND閃存(確切地說是78個)。很重要的一點是,這種存儲芯片附在有機基板上,即使采用八個芯片堆疊,它們的總厚度(560μm)仍小于普通芯片的厚度。遺憾的是,由于成本問題和引線鍵合技術的競爭,使用TSV(Through Silicon Via,硅通孔技術)的存儲器芯片堆疊目前尚未針對消費產品進行批量生產。目前,Samsung正在開發的下一代服務器產品,很可能考慮采用DDR4(雙信道四次同步動態隨機存取內存)SDRAM(同步動態存儲器)。
寬I / O存儲或邏輯堆疊
圖1左側第二個圖示顯示了一個寬I / O存儲器,它由低功耗和寬帶存儲器組成,通常具有數千個接口引腳。該I / O存儲器被稱為有源轉接板,能夠被具有TSV結構的CPU /logic或SoC支持,連接在有機基板上。由于智能手機等移動產品的需求,諸如Samsung公司等已經制造發布該樣品。不幸的是,設計公司的基礎設施(包括制定行業標準,商業模式和提出有競爭力的價格)都需要時間準備,還未完善。邏輯堆疊便屬于這一類。
寬I / O DRAM(HMC)
圖1右側的第三列圖示顯示了一個寬I / O DRAM。Samsung已經至少三年發表了有關此主題的論文,最后一次,在2011舊金山召開的IEEEISSCC會議上,Samsung展示了一個帶有TSV結構的主控制器邏輯芯片(或SoC)上有兩個DRAM的樣品,該芯片被稱為有源轉接板。對于這種DRAM,硅通孔和接口引腳的數量略多于1000個。JEDEC標準將此結構定義為在四個通道中具有1200個I/ O引腳(http://www.jedec.org/)。該寬I / O DRAM模塊附在有機基板上。近日,由Micron,Samsung,Altera,ARM,Hewlett-Packard,IBM,Microsoft,Open-Silicon,SKHynix和Xilinx等公司組成的HybridMemory Cube(HMC)聯盟宣布,將在今年年底前向公眾發布一個行業規范。該規范主要針對高性能網絡、工業、測試和測量應用。IBM還建議將此用于高端服務器。
無源轉接板的寬I / O接口(2.5DIC封裝)
圖1最右側圖示顯示了用于路由/通信/下一代服務器/高性能應用的寬I / O接口。摩爾定律芯片如memory/ ASIC / CPU / ...... 的I/ O數量在幾百到幾千之間,他們由一片具有TSV和再分配層(RDL)的硅片相連。圖1最右側示例從Xilinx[3-6]的論文中截取,其中FPGA(現場可編程邏輯門陣列)由TSMC的28nm工藝技術制造,轉接板為65nm工藝制程。頂部有四個RDL,可讓這四個FPGA在很短的距離內相互通信。
下面將對這四組潛在應用的技術流程和3D IC集成技術的HVM進行討論。HMC中存儲芯片堆疊和DRAM的厚度≤50μm。此外,有源和無源轉接板厚度≤200μm。本文僅僅考慮芯片-晶圓(C2W)鍵合(不探討材料和設備等)。盡管EDA(electronicdesign automation,電子設計自動化)非常重要,本文也不對其進行討論。同樣,像Samsung和TSMC這樣想要成為技術的縱向一體化公司(即做到這一切),也不在本文討論范圍。
TSV時代之前的技術流程
在TSV時代之前的技術流程已經被很好地定義和理解。TSV時代之前技術流程描述如下:
FEOL(前段)。這是IC制造的第一部分,其中對各個器件(例如晶體管或電阻器)進行了圖形化。該過程是從裸晶片到(但不包括)金屬層的沉積。FEOL通常在fab中進行。
BEOL(后段)。這是有源器件在晶片上布線連接的制造過程。該過程從第一層金屬開始到具有鈍化的PAD。它還包括絕緣體和金屬接觸,稱為MOL(中段)。術語“MOL”很少使用,此工藝常包含在BEOL中。同樣,BEOL通常在fab中完成。
OSAT(外包半導體組裝和測試)。當鈍化后的晶片從fab接收后,將進行電路測試/凸點/減薄/劃片/引線鍵合/倒裝芯片/注塑成型/植球/成品測試。
TSV時代的技術流程
TSV時代技術流程主要分三部分討論:
A)誰制造TSV?
B)誰負責MEOL?
C)誰執行關鍵步驟(包括FEOL,MOL,BEOL,TSV,MEOL,組裝和測試)以及誰將負責完成圖1所示的四種3D封裝制程。
A) 誰制造TSV
以下TSV制造工序將會對多種因素產生影響,因此必須予以區分。
Via-First工藝制備TSVs:TSVs在FEOL工藝之前制造,并且只能由fab完成。因為器件的制備(例如晶體管)比TSV重要得多,因此很難在fab中完成TSV工藝。
Via-Middle工藝制備TSVs:TSVs在FEOL(例如晶體管)和MOL(例如金屬接觸)之后,在BEOL(例如金屬層)之前制備。在這種工藝下,由于TSV制造過程介于它們之間,因此BEOL工藝不再包含MOL(圖2和圖3)。由于工藝流程和設備的兼容性,通過Via-Middle工藝制備的TSV通常也由fab完成。
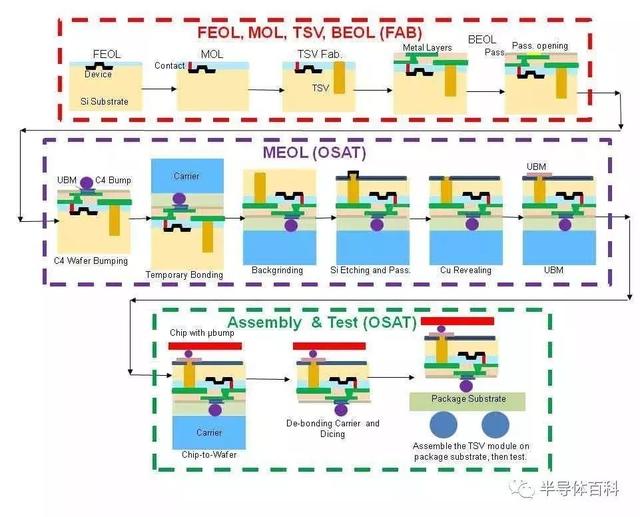
圖2:Critical steps and ownerships for (face-to-back) wide I/O memory using the TSVvia-middle fabrication process.
Via-Last工藝制造的TSVs(從晶圓正面):在FEOL,MOL和BEOL工藝之后制造TSV。迄今為止,沒有一篇論文發表過相關報道。
Via-Last工藝制造TSVs(從晶圓背面):在FEOL,MOL和BEOL工藝之后制造TSV。CMOS圖像傳感器就是一個例子。但嚴格來說,CMOS圖像傳感器不是3D IC集成工藝的示例。對于CMOS器件,Leti等人發表的論文提供了唯一可信的證據。但是,由于工藝和技術問題,應避免使用Via-Last工藝制造TSV(從晶圓背面)直到這些問題得到解決。

圖3:Critical steps and ownerships for (face-to-face) wide I/O memory using the TSVvia-middle fabrication process.
基于上述討論,似乎對應用于3D IC封裝技術有源器件晶片,使用via-middle工藝制造TSV更為理想。此外,由于fab已經擁有相關設備,具備相關專業知識技能,TSV應由fab廠制造,并且制造TSV的成本不到制造(≤32nm)器件晶片的成本的5%!
對于無源TSV轉接板又如何呢:當業界定義用于3D IC封裝的TSV流程時,還沒有無源轉接板。此外,由于無源轉接板中沒有有源器件,因此它們不適用上述提到的的任意工藝!
誰想要生產無源轉接板TSV:fab和OSAT都希望生產!它取決于版圖,設計和制造能力,尤其是RDL的線寬和間距。通常,OSAT可以實現幾微米的線寬和間距。否則,它就應該由fab生產。
B)誰負責MEOL工藝
對于HMC中DRAMs和存儲.芯片堆疊的厚度,以及考慮到有源和無源轉接板的厚度,所有制造的TSV都是盲孔。盲孔TSV工藝之后是焊料凸點/臨時粘合/減薄/ TSV露點/薄晶圓支撐轉移/剝離/清潔,這些過程統稱為MEOL(生產線的中端)。對于這項工作,除了縱向一體化公司公司(例如,TSMC和Samsung集團),最好由OSAT完成MEOL流程。
C)量產3D封裝的關鍵步驟分工
C.1)TSV Via-Middle工藝制造寬I / O存儲器(面對背):圖2顯示了該工藝的關鍵步驟和制備工廠。在FEOL(用于對器件進行圖案化)和MOL(用于形成金屬接觸)之后,通過五個關鍵步驟制造TSVs,即通孔制造。通孔是由深反應等離子蝕刻形成的(DRIE),電介質是通過等離子體增強化學氣相沉積的(PECVD),阻擋層和種子層通過物理氣相沉積(PVD),使用電鍍銅填充和化學機械拋光(CMP)去除覆蓋的銅。這些步驟之后是金屬層的堆積,最后是鈍化/開口(BEOL)。所有這些步驟都應在fab中完成。
MEOL首先通過凸點下金屬化(UBM)以及使用C4(普通晶圓凸點)焊接到整個晶片上。然后用粘合劑將TSV晶片臨時粘合到載體晶片上。再將TSV晶片反向研磨至銅填充TSV頂部幾微米。接著進行硅干法蝕刻,直到銅填充TSV頂部以下幾微米。之后,在整個晶片上進行低溫隔離SiN / SiO2沉積。然后使用CMP去除SiN / SiO2和Cu以及Cu填充TSV(Cu顯露)的晶種層。最后,在銅填充TSV的頂部制備UBM。所有這些步驟應由OSAT完成。
分別用微小的焊料凸點或帶有焊帽的Cu柱對存儲器晶片進行微凸點處理。然后將晶片切成帶有微凸點/Cu柱的單個芯片。這些步驟也應由OSAT完成。
接下來是芯片到晶圓(C2W)的鍵合,如微凸點存儲芯片(通過自然回流或熱壓縮)與TSV晶片鍵合。在C2W面對背鍵合之后,載體晶片從TSV晶片上剝離下來。隨后將TSV晶片切成單獨的TSV模塊。將該TSV模塊(自然)回流焊接到封裝基板上,進行測試。所有這些C2W鍵合,切割,組裝和測試步驟均應由OSAT完成。
C.2)TSV Via-Middle工藝制造寬I / O存儲器(面對面):FEOL,MOL,TSV和BEOL過程與TSV via-middle(面對背)工藝流程完全相同。但是,接下來的工藝流程是不同的。TSV晶片不是在UBM后使用C4技術焊接到載體晶片上,而是臨時連接到載體#1。然后,對TSV晶片進行背面研磨,并完成Cu顯露和UBM。這些步驟之后進行C4工藝,并臨時粘合到第二個載體#2。然后,將載體#1從TSV晶片上剝離下來,并進行C2W(面對面)鍵合。在C2W鍵合之后,將載體#2從TSV晶片上剝離。隨后將TSV晶片切成單獨的TSV模塊。將該TSV模塊回流焊接到封裝基板上,然后進行測試。關鍵步驟如圖3所示。
C.3)TSV Via-Last工藝(從背面)制造寬I / O存儲器(面對背):圖4顯示了該工藝的關鍵步驟和制備工廠。在FEOL(對器件進行圖案化),MOL(形成金屬接觸)和BEOL(構建金屬層以及鈍化/開口)之后進行UBM制備和C4工藝。然后,將該結構臨時和載體晶片鍵合。再進行背面研磨,TSV制造和鈍化/開口以及UBM。
接下來是C2W面對背鍵合,將載體晶片從TSV晶片上剝離,然后將TSV晶片切成單獨的TSV模塊。再將該TSV模塊回流焊接到封裝基板上進行測試。

圖4: Critical steps andownerships for (face-to-back) wide I/O memory using the TSV via-last from thebackside fabrication process.
C.4)TSV Via-Last工藝(從背面)制造寬I / O存儲器(面對面):FEOL,MOL和BEOL工藝與和面對背TSV via-last(從背面)過程完全相同。但是,對于面對面情況而言,在UBM步驟之后,器件晶片臨時粘合到載體#1如圖5所示。然后,對背面進行背面研磨,TSV加工和鈍化/開口處理。在這些過程之后,制備UBM,進行C4工藝,并臨時粘合至載體#2。然后完成與載體#1的剝離。

圖5:Critical steps and ownerships for (face-to-face) wide I/O memory using the TSVvia-last from the backside fabrication process.
完成上述過程后,接下來進行C2W面對面粘合。在C2W鍵合之后,載體#2晶片從TSV晶片上剝離并切割成單獨的TSV模塊。TSV模塊將焊接在封裝基板上,然后進行測試。
從圖4和圖5可以看出,TSV既可以由fab制造也可以由OSAT制造。然而,由于工藝流程的關系,fab實現這一目標的機會非常渺茫。(一旦晶片離開fab由OSAT接收處理,晶片幾乎不可能再回到fab進行進一步處理。)同樣,由于技術問題,例如擊中晶片中各種嵌入式對準目標, x,y和z方向(要使晶片頂側上的金屬層對齊以及從背面形成的TSV定位),這對于OSAT來說也是非常具有挑戰性的。因此,在解決這些問題之前,應避免使用TSV via-last(從背面)制造工藝
C.5)TSV Via-Middle工藝制造寬I / O DRAM:在DRAM和SoC/logic晶片的FEOL,MOL,TSV和BEOL之后,SoC /logic晶圓將按照圖2(C.1)所示的面對背,或圖3 (C.2)面對面工藝步驟進行操作。對于DRAM,首先要進行UBM,然后是整個晶圓的微凸點工藝。在這些過程之后,將臨時粘合到載體晶片,進行背面研磨減薄,銅暴露和UBM。再依次進行載體晶圓剝離和將TSV DRAM晶圓切成單個TSV DRAM芯片,如圖6所示。
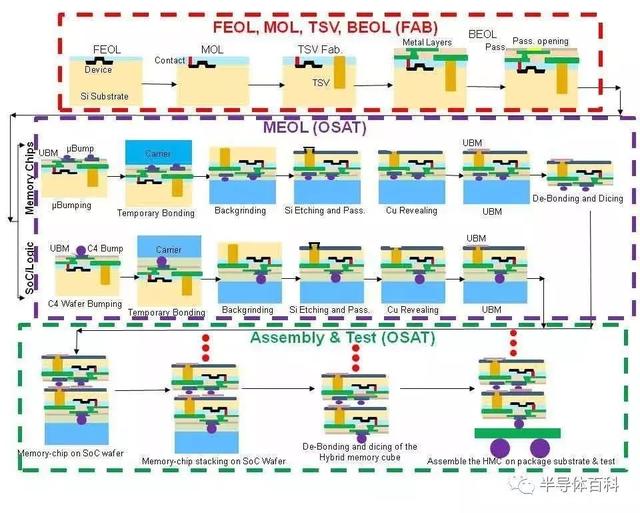
圖6:Critical steps and ownerships for wide I/O DRAM using the TSV via-middlefabrication process.
下一個過程是C2W(DRAM芯片到SoC/Logic晶片)鍵合(例如,2堆疊,4堆疊,6堆疊或8堆疊)。在C2W鍵合之后,載體晶片從SoC /Logic晶圓剝離并切割成單獨的混合封裝體(DRAM堆疊+SoC /Logic)。這些步驟之后,將二次成型的混合存儲立方體組裝在封裝基板上,然后進行測試。
C.6)TSV Via-Middle工藝制造寬儲存器芯片堆疊:存儲器芯片(DRAM或NAND閃存)堆疊的關鍵步驟和制備工廠與寬I / O DRAM情況完全相同,如圖6(C.5)所示。然而,不同于寬I / O DRAM情況下采用C2W鍵合,內存芯片堆疊是通過首先堆疊各個TSV芯片然后將它們連接到封裝基板上并且采用灌膠成型來實現的。在這些步驟之后,將TSV存儲器芯片堆疊模塊連接到印刷電路板上,例如雙列直插式存儲器模塊(RDIMM)。
C.7)2.5D IC封裝技術制備TSV / RDL無源轉接板:圖7顯示了關鍵步驟和制備工廠。在一塊dummy硅(無有源器件)上沉積鈍化層之后,制作TSV,構建RDL并進行鈍化/開口。在UBM之后,將TSV晶片臨時粘合到載體#1。然后進行背面研磨,硅蝕刻,低溫鈍化和銅暴露。其后,完成UBM,C4工藝以及與載體#2的臨時粘合。不帶TSV的器件晶圓分別用微焊料凸點或帶有焊帽的Cu柱對存儲器晶片進行微凸點處理。再將器件晶片切成有微凸點/Cu柱的單個芯片。
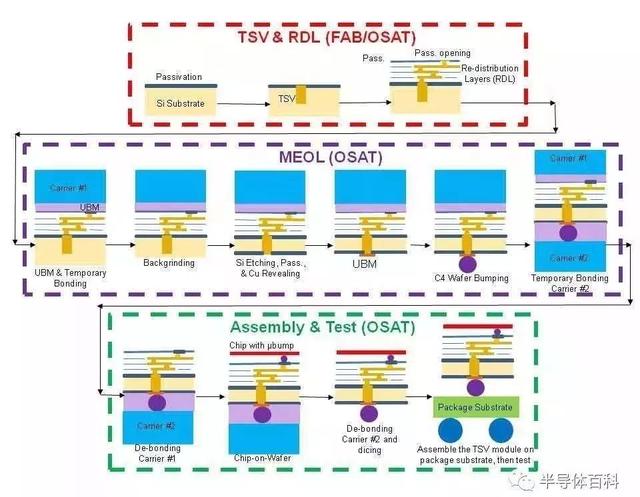
圖7:Critical steps and ownerships for 2.5D IC integration with a TSV/RDL passiveinterposer.
接下來要完成的工作是剝離載體#1,進行C2W鍵合(器件芯片與TSV晶片的鍵合)。C2W鍵合之后,載體#2被剝離并且TSV晶片被切割成單獨的TSV模塊。最后,TSV模塊可以組裝在封裝基板上進行測試。圖7中可以看出TSV和RDL既可以由fab制造也可由OSAT制造。它取決于布局,設計和制造能力,尤其是RDL的線寬和間距。通常,OSAT可以完成幾微米的線寬和間距。否則,它應該由fab完成。除了像TSMC這樣的縱向一體化公司希望完全在內部進行晶圓級封裝工藝(CoWoS)之外,大多數設計公司更偏向由fab(例如,UMC和GlobalFoundries)來制造盲孔TSV以及無源轉接板的RDL。然后,fab將未完成的“ TSV轉接板”移交給OSAT進行MEOL(焊料凸點/臨時鍵合/薄晶圓支撐轉移/背面研磨/ TSV顯露/剝離/清潔),組裝和測試。對于未完成的TSV器件晶片也是如此。

