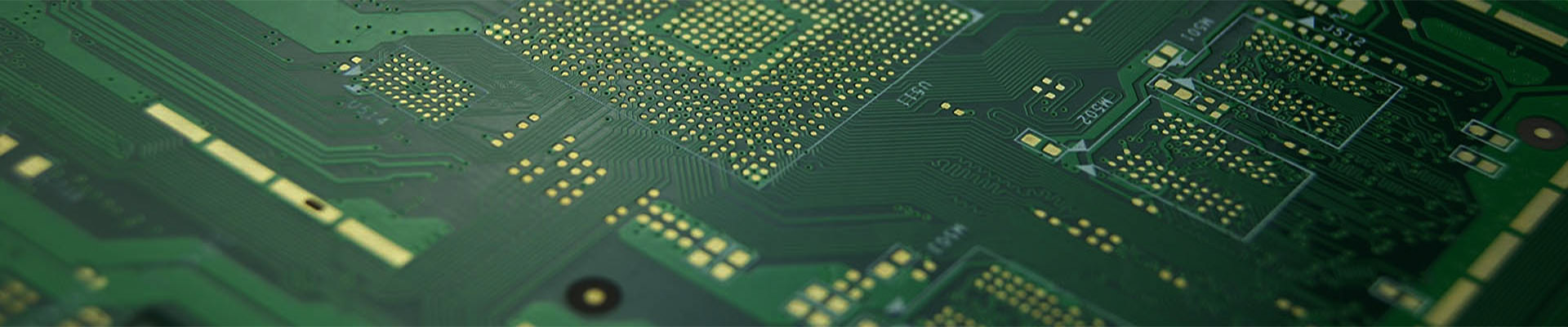

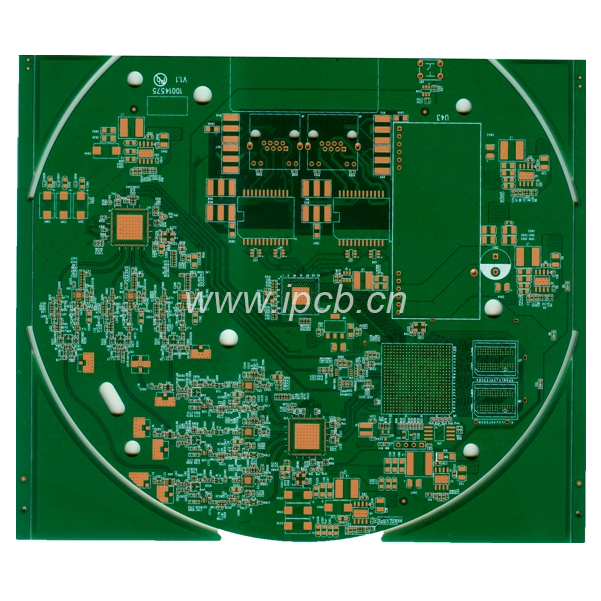
目前ENIG+OSP已經廣泛運用于高精密線路板的設計制作中。用ENIG良好的保護性加上OSP良好的可焊性是無鉛化生產替代HSAL的一種解決辦法。
化學鍍鎳/金是在印制電路板做上阻焊膜后,對裸露出來需要鍍金屬的部分采用的一種表面處理方式。由于科技的發展,PCB上的線寬間距變小,表面封裝增多,這就要求連接盤或焊墊有良好的共面性和平坦度,要求PCB不能彎曲。化學Ni/Au表面鍍層則可滿足上述的要求,另外由于它表層的金比較穩定、防護性好,所以它的存儲時間也和鉛錫差不多。
由于這種鎳/金的鍍層是在印制電路板做上阻焊膜后制作的,所以只能采用化學鎳/金的方式來實現選擇性涂覆。作為PCB的表面鍍層,鎳層厚度一般為5μm,而金厚一般在0.050.1μm之間,作為非可鍍焊層Au的厚度不能太高,否則會產生脆性和焊點不牢的故障,如果太薄則防護性不好。其缺點是可焊性較差,容易發生黑盤的缺陷。
有機可焊性保護劑(OSP),又稱為防氧化助焊劑、Entek。這種方法是PCB完成所有制作工藝,并經過電測試及初次表觀的檢驗后,經OSP處理后在裸銅焊盤和通孔內而得到一種耐熱型的有機可焊性膜。這種有機耐熱可焊性膜厚度為0.3~0.5μm之間,分解溫度可以達到300℃左右。
OSP技術由于其具有高的熱穩定性、致密性、疏水性等許多優點因而迅速得到推廣運用。
其主要優點還有:
1.能夠克服線寬間距小的問題,其鍍層表面很平坦。
2.工藝簡單,操作方便,污染少,易于操作、維護和自動化。
3.成本低廉,可焊性好。
其缺點是保護膜極薄,容易劃傷,因此在生產和運輸過程中要十分小心。另外其可焊性僅僅依靠該層保護膜,一旦膜被損害可焊性就大大降低了。因此它放置的時間也很短。
我司專業從事PCB制造有多年豐富的PCB制造經驗,致力于以
合理的價格為全球客戶提供快速、高品質的PCB板,每一塊電路板都按照嚴格的標準制作,符合IPC 、
RoHS等標準,確保PCB電路板滿足客戶要求。 歡迎咨詢。
品 名: 6層一階數碼板
板 材:FR-4
層 數:6層
板 厚:1.0mm
表面工藝:沉金+OSP
銅 厚:1OZ
顏 色:綠油白字
最小線寬/線距:4mil/4mil
最小孔徑:機械控0.2mm,激光孔0.1mm
用 途 : 數碼類產品